
企业微信客服:15816852154 (微信同号)


企业微信客服:15816852154 (微信同号)


光刻机是在半导体领域必不可少的设备,无论生产制造什么样的芯片,都脱离不了光刻机,如果说航空发动机代表了人类科技领域发展的顶级水平,那么光刻机则是半导体工业界最为耀眼的明珠,其具有技术难度最高、单台成本最大、决定集成密度等特点。而目前最为先进的光刻机是有荷兰ASML生产的EUV光刻机,华为麒麟990 5G版首次采用了7nm EUV技术,EUV技术也叫紫外光刻(Extreme Ultraviolet Lithography),它以波长为10-14nm的极紫外光作为光源的光刻技术。具体为采用波长为13.5nm的紫外线,目前1-4代光刻机使用的光源都属于深紫外光,而5代EUV光刻机则属于极紫外光。
 本文主要介绍MicroFab的Inkjet技术在EVU上的应用。如图1所示为光刻机的工作原理图。光刻是制造芯片的关键技术,光刻机通过光源发出的光通过具有图形的光罩(Reticle Mask,又称掩模版)在经过缩图透镜将光罩的图案照射到涂有光刻胶的硅片上,光刻胶在见光后会发生性质变化,从而使光罩上的图形在硅片上刻录,使硅片具有电子路线的作用。
本文主要介绍MicroFab的Inkjet技术在EVU上的应用。如图1所示为光刻机的工作原理图。光刻是制造芯片的关键技术,光刻机通过光源发出的光通过具有图形的光罩(Reticle Mask,又称掩模版)在经过缩图透镜将光罩的图案照射到涂有光刻胶的硅片上,光刻胶在见光后会发生性质变化,从而使光罩上的图形在硅片上刻录,使硅片具有电子路线的作用。
EUV光源技术的激光等离子体(LPP, Laser Produced Plasma)技术是极紫外光源主要发生。EUV的产生是通过激光将锡滴作为燃料使其产生等离子体的过程。LPP EUV是将高功率的二氧化碳激光打在直径约为20μm的锡液滴上,通过高功率激光使锡滴膨胀蒸发形成锡蒸汽,然后将蒸汽加热产生等离子体,这个过程会产生极紫外光。产生EUV的燃料可以是锡(Sn)、氙(Xe)、锂(Li),由于氙(Xe)和锂(Li)在实际测试中其产生的功率及工艺无法达到生产要求,锡滴被作为EUV制造的理想燃料。
LPP EUV系统主要包括锡滴发生器、激光器、源收集器、辐射收集器组成。
锡滴发生器用于产生作为燃料的锡液滴,用于产生20μm的锡滴;
激光器用于提供能量源,用于激发锡滴,通过引导激光束至锡滴来激发锡滴产生等离子体;
源收集器是一个中空的腔体,其内部为真空环境用于支持等离子体;
辐射收集器接收EUV辐射,在产生等离子体的过程中会发生EUV辐射,通过辐射收集器进行收集并将辐射狙击成EUV光束进行后续工作。

其步骤为:
锡液发生器使锡液滴落入真空室③。
脉冲式高功率激光器①击中从旁飞过的锡液滴②—每秒 50,000 次。Laser分为两部分,前脉冲和功率放大器。前脉冲和主脉冲击中锡液使其气化。
锡原子被电离,产生高强度的等离子体。
收集镜捕获等离子体向所有方向发出的 EUV 辐射,汇聚形成光源。
将集中起来的光源传递至光刻系统④以曝光晶片⑤。
EVU的锡液滴发生装置主要是由MicroFab提供的喷墨压电头组装而成。锡滴发生器主要包含储液器、锡材料、定制化的压电喷头、加热器。储液器用于存储燃料液体,燃料液体由锡材料制成,在超过235℃高温下融化,在气体压力作用下通过压电喷头挤出,由于瑞利破碎形成液滴。
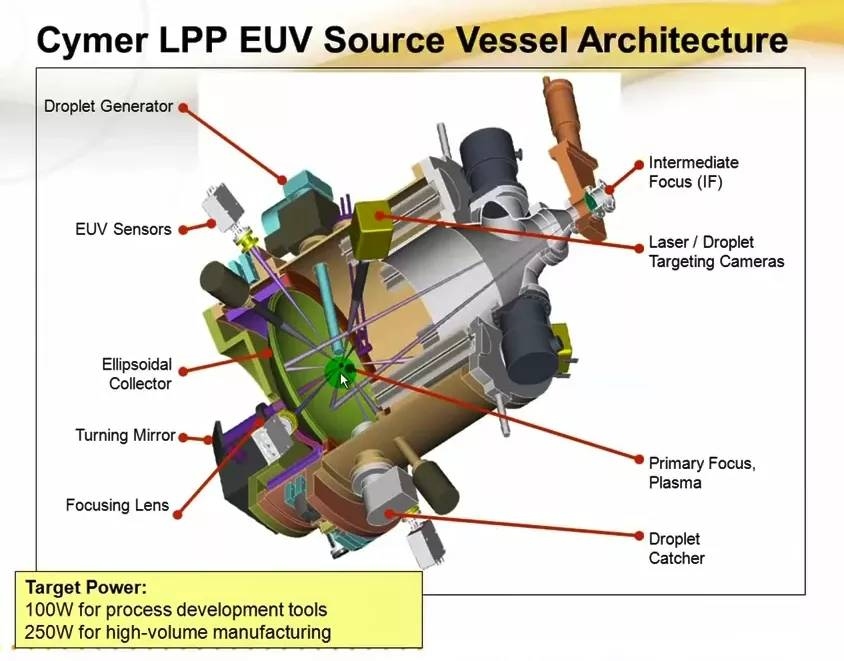 锡滴产生原理
定制化的压电喷头中心一端有3-5μm的小孔为毛细玻璃管,毛细玻璃管外壁粘结压电陶瓷,压电陶瓷在电信号的作用下会发生形变产生振动,振动从压电陶瓷传递至毛细玻璃管。储液器连接至毛细玻璃管的另一端,储液器中的锡材料在加热到高于235℃时形成锡溶液,锡溶液在气压作用下从毛细玻璃管挤出,产生束流。在没有压电陶瓷的情况下,束流将在液滴发生一段距离(约喷嘴直径的100-1000倍)后自然破碎形成液滴,其液滴直径大约为喷嘴直径的2倍或略小,两液滴间隔是喷嘴直径的大约4.5倍,虽然毛细玻璃管外壁没有压电陶瓷的作用液可以产生瑞利破碎,但压电陶瓷可以通过控制毛细玻璃管内的压力控制瑞利破碎,从而使形成液滴的位置更加明确。
锡滴产生原理
定制化的压电喷头中心一端有3-5μm的小孔为毛细玻璃管,毛细玻璃管外壁粘结压电陶瓷,压电陶瓷在电信号的作用下会发生形变产生振动,振动从压电陶瓷传递至毛细玻璃管。储液器连接至毛细玻璃管的另一端,储液器中的锡材料在加热到高于235℃时形成锡溶液,锡溶液在气压作用下从毛细玻璃管挤出,产生束流。在没有压电陶瓷的情况下,束流将在液滴发生一段距离(约喷嘴直径的100-1000倍)后自然破碎形成液滴,其液滴直径大约为喷嘴直径的2倍或略小,两液滴间隔是喷嘴直径的大约4.5倍,虽然毛细玻璃管外壁没有压电陶瓷的作用液可以产生瑞利破碎,但压电陶瓷可以通过控制毛细玻璃管内的压力控制瑞利破碎,从而使形成液滴的位置更加明确。
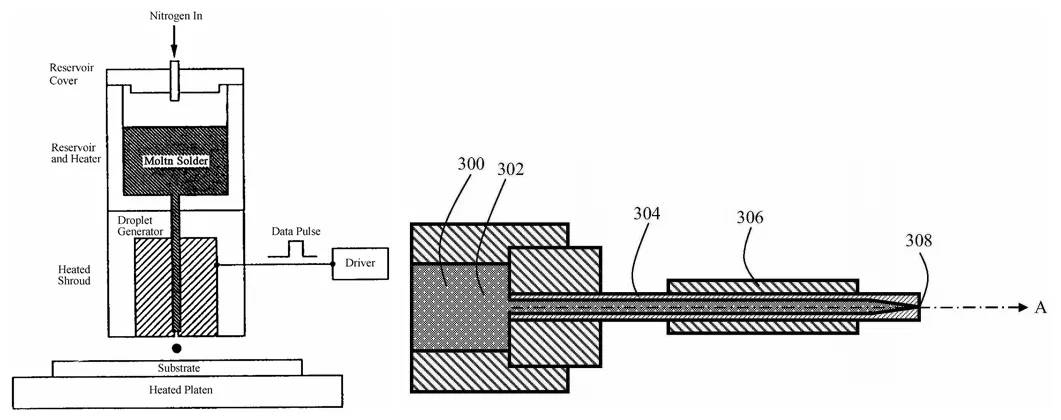 如果喷嘴的直径为4μm,燃料液滴可以通过瑞利破碎形成约7μm直径的液滴,液滴分开大约18μm的距离,喷嘴的液滴产生速率对应的瑞利频率与喷嘴处燃料的平均速度和喷嘴的直径相关:
喷嘴稳定性
喷嘴的稳定性或堵塞是任何喷墨打印应用时在使用喷嘴期间可能会出现的问题。喷头堵塞可能是锡溶液中的污染物造成的,喷嘴堵塞会造成喷嘴的损坏或维护需求,并因此限制光刻机的后续工作。
通过在喷嘴前端增加过滤器可以过滤比喷嘴直径大的障碍物,然而,比喷嘴直径小的障碍物 和喷嘴内的障碍物可能导致喷嘴的有效几何结构的改变。
有效几何结构的改变可能导致所生成的液滴束流的参数的改变,例如液滴形状、尺寸,或更可能的是液滴束流的轨迹的方向。在许多应用中,这些参数将需要满足严格的要求。尤其在EUV辐射源中,液滴生成装置在液滴束流的轨迹方面的要求将极其严格。例如,在等离子体形成位置处,液滴位置可以需要精确至几个微米,但是喷嘴本身需要放置相对远离等离子体形成位置,例如几十厘米左右的距离。这导致液滴束流的轨迹的方向稳定性要求也许小于10微弧度。总的结果是,即使是沉积在喷嘴的内表面上的极小的微粒污染物也可以将喷嘴的有效几何结构改变至确保不满足方向稳定性要求的这种 程度。这又可以对辐射源的操作产生有害的影响并因此对光刻设备作为整体产生有害的影响,例如在生成辐射方面。
颗粒40是污染物的一个示例。污染物可以是微粒的形式,或可以是用以形成液滴束流的燃料内存在的其它任何物体(例如,薄片、结块、溶液等)。污染物可能由于燃料的氧化引起。例如,如果燃料是锡,则污染物可能是锡氧化物颗粒等。
▲ 图5 喷嘴处污染颗粒对锡液滴形成的影响
为了防止喷嘴被污染物堵塞,由此导致喷嘴的有效几何结构的改变。一种提出的解决方案是在燃料流动系统中使用细的或较细的过滤器以防止具有小于喷嘴直径的平均直径的污染物(即,喷嘴的开口)到达喷嘴。然而,这随后可以导致燃料流动系统整体的堵塞(即,在该过滤器处),这又导致需要定期维护或修复液滴生成装置,由此造成辐射源和/或光刻设备作为整体的相当长的停工时间。
为了解决喷嘴堵塞的问题,喷嘴内表面特意地配置成防止在用以形成燃料液滴的燃料中存在的污染物沉积在该内表面上,这可以通过确保内表面对污染物是不具有粘性的或通过确保内表面足够光滑以避免这样的沉积发生来实现。这种方法的优点在于,不促成 进一步的堵塞等。相反,污染物被冲洗离开燃料流动系统,并且尤其是冲离喷嘴,因此防止 了堵塞,并因此防止喷嘴的有效几何结构的改变。
涂层可以是多种不同材料中的一种或包括多种不同材料中的一种,例如 :氟化物(CaF2,BaF2);氮化物 ;DLC(类金刚石碳);特氟龙(即,PTFE- 聚四氟乙烯);在一些情况下,上述材料中的任一种或更多种可以用作涂层。然而,类金刚石碳可能不总是合适的,这依赖于喷嘴的纵横比,喷嘴的纵横比可能有碍类金刚石碳涂层容易 应用的沉积(例如使用气相沉积)。氮化物可能会太粗糙,并且可能不足以防止污染物在喷嘴内的聚积。由于可能太难以应用氟化物作为涂层的事实,氟化物可能是不合适的。相反,已经发现PTFE和通过溶胶凝胶涂覆工艺得到的材料(例如基于硅或硅石的涂层,例如诸如 SiC2:CH3)是特别合适的,满足上面限定的全部要求。
液滴加速
燃料液滴需要具有高的速度(例如100m/s或更高),这是因为速度越快,燃料液滴之间的间隔距离越大,从而减小由前面的燃料液滴生成的等离子体与下一个燃料液滴相互作用的风险,被输送至等离子体形成位置的液滴的间隔应该为1mm或更大。
为了获得高速液滴,需要对液滴发生器中发生的液滴进行电场加速,液滴发生器前方增加第一电级和第二电级,液滴发生器与第一电极连接调制电压源,第一电极和第二电极连接恒定电压源,第一电极接地,调制电压源施加一个从恒定正压Va切换到恒定负压-Va的周期电压信号,调制电压源的频率为液滴发生器频率设置为特定关系,第一电极和第二电极中间施加一个恒定电压源。当液滴发生器产生液滴时,液滴带电(正电荷或负电荷),其所带电荷与第一电极电荷相反,液滴在电场作用下加速穿过第一电极到达第二电极,通过调制电压源的信号周期与液滴发生器的周期,使其产生的液滴带电情况类似为“+++---”,当液滴束流进入第一电极和第二电极中间时,携带“+”电荷的粒子将减速,携带“-”电荷的粒子将加速,一段束流内的液滴将融合变为一个中性的大液滴。
▲ 图6 液滴加速示意图
电压Va改变极性时,在液滴发生器和第一电极之间进行的少量液滴可以被减速,因为他们是“错误的”电荷,但是如果液滴发生器和第一电极之间的距离小,则这些液滴数量少,表示束流中的仅小部分液滴,并且不会显著影响液滴的整体加速。
在液滴束流的第二半322已经发射之后,由调制电压源312施加的电压变为零并且液滴不带电。电压可以保持在零位时间段t沉默,其与带电液滴的束流的末端和带电液滴的下一个束流的开头之间的时间段对应。时间段t沉默可以是任何合适的时间段。在一个实施例中,时间段t沉默可以是零,即,使得电压立即从-Va变为Va。在一个实施例中,在液滴束流的第二半的末端和随后的液滴束流的第一半的开始之间没有间隙。
如果存在数量相同的带正电的和带负电的液滴并且全部这些带电液滴具有相同幅值的电荷,则所形成的聚结的较大的液滴将是电中性的。然而,可以通过形 成 数 量不等的正、负带电粒子(其可以通过使Va高的时间段和Va低的时间段不相等来实现)和 / 或通过具有幅值不等的正和负电荷(其可以通过具有不同幅值的正Va和负Va来实现)形成具有电荷的聚结颗粒。如果聚结的液滴被形成在具有电荷的电极314和318之间,则这可以允许实现进一步的加速。
聚合形成的燃料液滴具有中性电荷。中性液滴到达等离子形成位置,并可以用以生成用于发射EUV辐射的等离子体。
参考资料:
[1] 新一代制程的关键:13.5奈米的「极端」紫外光
[2] 芯片的光刻技术
[3] 浸没式光刻原理浅析
[4] 集成电路先进光刻技术与版图设计优化
[5] 光刻技术的原理和EUV光刻技术前景
[6] 光刻机详解一:光源系统篇
[7] 光刻机详解二:光学邻近校正
[8] 光刻机结构组成及工作原理
[9] 光刻机发展史
[10] CN201280042339-辐射源和光刻设备
[11] ASML 简介
[12] 美国MicroFab官网
[13] Vinokhodov A Y , Krivokorytov M S , Sidelnikov Y V , et al. High brightness EUV sources based on laser plasma at using droplet liquid metal target[J]. Quantum Electronics, 2016, 46(5):473-480.
如果喷嘴的直径为4μm,燃料液滴可以通过瑞利破碎形成约7μm直径的液滴,液滴分开大约18μm的距离,喷嘴的液滴产生速率对应的瑞利频率与喷嘴处燃料的平均速度和喷嘴的直径相关:
喷嘴稳定性
喷嘴的稳定性或堵塞是任何喷墨打印应用时在使用喷嘴期间可能会出现的问题。喷头堵塞可能是锡溶液中的污染物造成的,喷嘴堵塞会造成喷嘴的损坏或维护需求,并因此限制光刻机的后续工作。
通过在喷嘴前端增加过滤器可以过滤比喷嘴直径大的障碍物,然而,比喷嘴直径小的障碍物 和喷嘴内的障碍物可能导致喷嘴的有效几何结构的改变。
有效几何结构的改变可能导致所生成的液滴束流的参数的改变,例如液滴形状、尺寸,或更可能的是液滴束流的轨迹的方向。在许多应用中,这些参数将需要满足严格的要求。尤其在EUV辐射源中,液滴生成装置在液滴束流的轨迹方面的要求将极其严格。例如,在等离子体形成位置处,液滴位置可以需要精确至几个微米,但是喷嘴本身需要放置相对远离等离子体形成位置,例如几十厘米左右的距离。这导致液滴束流的轨迹的方向稳定性要求也许小于10微弧度。总的结果是,即使是沉积在喷嘴的内表面上的极小的微粒污染物也可以将喷嘴的有效几何结构改变至确保不满足方向稳定性要求的这种 程度。这又可以对辐射源的操作产生有害的影响并因此对光刻设备作为整体产生有害的影响,例如在生成辐射方面。
颗粒40是污染物的一个示例。污染物可以是微粒的形式,或可以是用以形成液滴束流的燃料内存在的其它任何物体(例如,薄片、结块、溶液等)。污染物可能由于燃料的氧化引起。例如,如果燃料是锡,则污染物可能是锡氧化物颗粒等。
▲ 图5 喷嘴处污染颗粒对锡液滴形成的影响
为了防止喷嘴被污染物堵塞,由此导致喷嘴的有效几何结构的改变。一种提出的解决方案是在燃料流动系统中使用细的或较细的过滤器以防止具有小于喷嘴直径的平均直径的污染物(即,喷嘴的开口)到达喷嘴。然而,这随后可以导致燃料流动系统整体的堵塞(即,在该过滤器处),这又导致需要定期维护或修复液滴生成装置,由此造成辐射源和/或光刻设备作为整体的相当长的停工时间。
为了解决喷嘴堵塞的问题,喷嘴内表面特意地配置成防止在用以形成燃料液滴的燃料中存在的污染物沉积在该内表面上,这可以通过确保内表面对污染物是不具有粘性的或通过确保内表面足够光滑以避免这样的沉积发生来实现。这种方法的优点在于,不促成 进一步的堵塞等。相反,污染物被冲洗离开燃料流动系统,并且尤其是冲离喷嘴,因此防止 了堵塞,并因此防止喷嘴的有效几何结构的改变。
涂层可以是多种不同材料中的一种或包括多种不同材料中的一种,例如 :氟化物(CaF2,BaF2);氮化物 ;DLC(类金刚石碳);特氟龙(即,PTFE- 聚四氟乙烯);在一些情况下,上述材料中的任一种或更多种可以用作涂层。然而,类金刚石碳可能不总是合适的,这依赖于喷嘴的纵横比,喷嘴的纵横比可能有碍类金刚石碳涂层容易 应用的沉积(例如使用气相沉积)。氮化物可能会太粗糙,并且可能不足以防止污染物在喷嘴内的聚积。由于可能太难以应用氟化物作为涂层的事实,氟化物可能是不合适的。相反,已经发现PTFE和通过溶胶凝胶涂覆工艺得到的材料(例如基于硅或硅石的涂层,例如诸如 SiC2:CH3)是特别合适的,满足上面限定的全部要求。
液滴加速
燃料液滴需要具有高的速度(例如100m/s或更高),这是因为速度越快,燃料液滴之间的间隔距离越大,从而减小由前面的燃料液滴生成的等离子体与下一个燃料液滴相互作用的风险,被输送至等离子体形成位置的液滴的间隔应该为1mm或更大。
为了获得高速液滴,需要对液滴发生器中发生的液滴进行电场加速,液滴发生器前方增加第一电级和第二电级,液滴发生器与第一电极连接调制电压源,第一电极和第二电极连接恒定电压源,第一电极接地,调制电压源施加一个从恒定正压Va切换到恒定负压-Va的周期电压信号,调制电压源的频率为液滴发生器频率设置为特定关系,第一电极和第二电极中间施加一个恒定电压源。当液滴发生器产生液滴时,液滴带电(正电荷或负电荷),其所带电荷与第一电极电荷相反,液滴在电场作用下加速穿过第一电极到达第二电极,通过调制电压源的信号周期与液滴发生器的周期,使其产生的液滴带电情况类似为“+++---”,当液滴束流进入第一电极和第二电极中间时,携带“+”电荷的粒子将减速,携带“-”电荷的粒子将加速,一段束流内的液滴将融合变为一个中性的大液滴。
▲ 图6 液滴加速示意图
电压Va改变极性时,在液滴发生器和第一电极之间进行的少量液滴可以被减速,因为他们是“错误的”电荷,但是如果液滴发生器和第一电极之间的距离小,则这些液滴数量少,表示束流中的仅小部分液滴,并且不会显著影响液滴的整体加速。
在液滴束流的第二半322已经发射之后,由调制电压源312施加的电压变为零并且液滴不带电。电压可以保持在零位时间段t沉默,其与带电液滴的束流的末端和带电液滴的下一个束流的开头之间的时间段对应。时间段t沉默可以是任何合适的时间段。在一个实施例中,时间段t沉默可以是零,即,使得电压立即从-Va变为Va。在一个实施例中,在液滴束流的第二半的末端和随后的液滴束流的第一半的开始之间没有间隙。
如果存在数量相同的带正电的和带负电的液滴并且全部这些带电液滴具有相同幅值的电荷,则所形成的聚结的较大的液滴将是电中性的。然而,可以通过形 成 数 量不等的正、负带电粒子(其可以通过使Va高的时间段和Va低的时间段不相等来实现)和 / 或通过具有幅值不等的正和负电荷(其可以通过具有不同幅值的正Va和负Va来实现)形成具有电荷的聚结颗粒。如果聚结的液滴被形成在具有电荷的电极314和318之间,则这可以允许实现进一步的加速。
聚合形成的燃料液滴具有中性电荷。中性液滴到达等离子形成位置,并可以用以生成用于发射EUV辐射的等离子体。
参考资料:
[1] 新一代制程的关键:13.5奈米的「极端」紫外光
[2] 芯片的光刻技术
[3] 浸没式光刻原理浅析
[4] 集成电路先进光刻技术与版图设计优化
[5] 光刻技术的原理和EUV光刻技术前景
[6] 光刻机详解一:光源系统篇
[7] 光刻机详解二:光学邻近校正
[8] 光刻机结构组成及工作原理
[9] 光刻机发展史
[10] CN201280042339-辐射源和光刻设备
[11] ASML 简介
[12] 美国MicroFab官网
[13] Vinokhodov A Y , Krivokorytov M S , Sidelnikov Y V , et al. High brightness EUV sources based on laser plasma at using droplet liquid metal target[J]. Quantum Electronics, 2016, 46(5):473-480.
手机:15816852154
(微信同号)
座机:0755-89811108
邮箱:sales@powertronics.com.cn